Resist Process Information
ZEP-520A Process Information
Dilutions
Here are the ZEP dilutions at the WNF:| Undiluted (Identified as "Z0" on the bottle cap) |
| 1:1 |
| 1:3 |
| 1:4 |
Spin-Speed Thickness Data
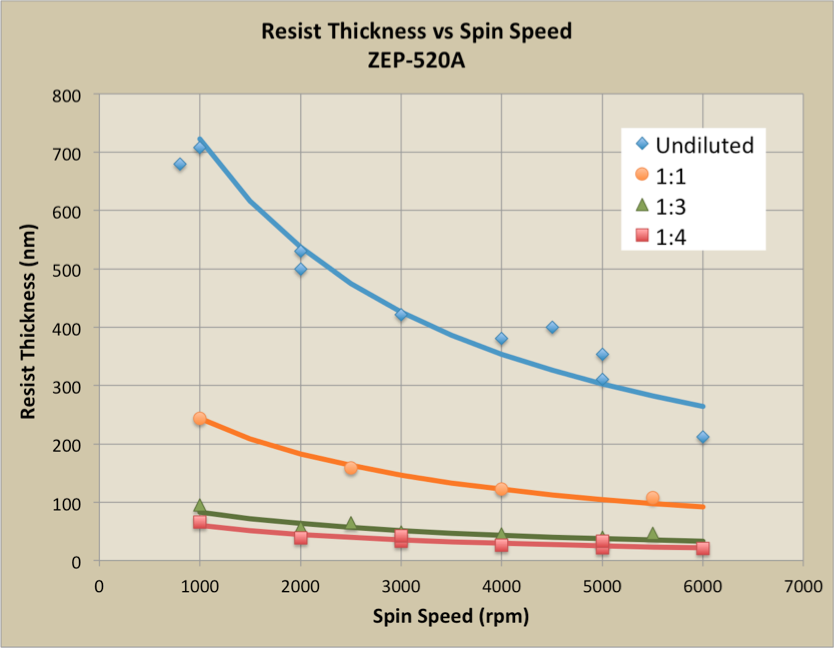
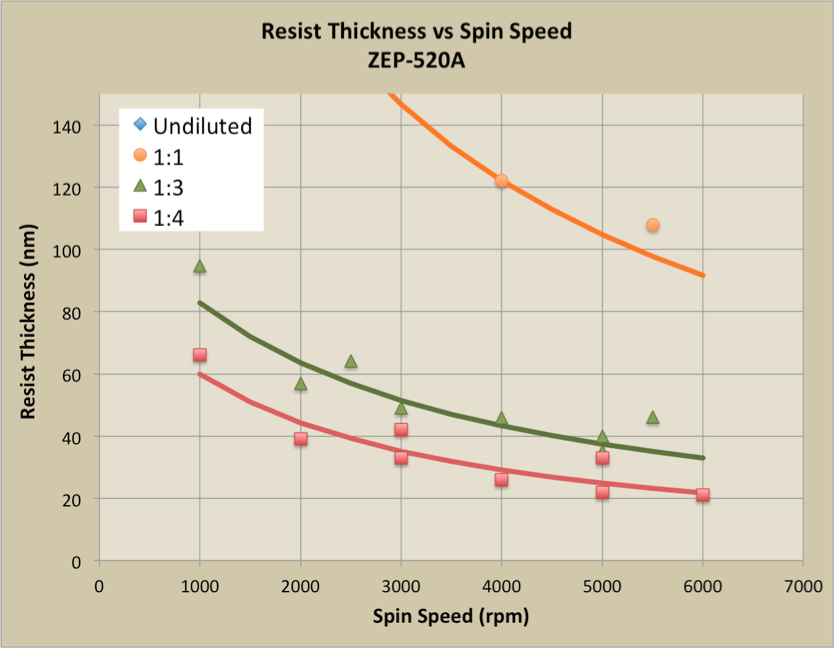
(Updated 08-Feb-2013, with data from dilutions we have now.)
Typical Process Parameters
1. Dispense resist, covering about 1/3 to 1/2 of sample diameter
2. Spin resist, 60 seconds.
3. Bake resist, hotplate, 180 C, 180 seconds.
4. Expose. Dosing ranges from 200-500 µC/cm^2, depending on substrate, feature size and density.
5. Develop. 60-120 seconds, Amyl Acetate.
6. Rinse, IPA, 15 seconds. N2 dry.
Notes
- In general, ZEP has excellent adhesion to most materials. Very thin layers will need a very clean substrate.
- HMDS does not generally help adhesion. Cleaning the substrate with piranha or an O2 plasma (ie, barrel ash) will help adhesion.
- ZEP has somewhat better etch resistance than PMMA, but generally worse than photoresist
- ZEP can be stripped in NMP (best), Dichloromethane/DCM, Acetone (ok), or an O2 plasma
- When stripping or during liftoff, be sure to keep the substrate completely wet at all times, until after final rinsing in IPA is completed, or you will have a hard-to-remove residue.
